发光二极管(LED)失效分析(图)
|
上传人:蔡伟智 上传时间: 2008-04-09 浏览次数: 4580 |
1 引言
和半导体器件一样,发光二极管(LED)早期失效原因分析是可靠性工作的重要部分,是提高LED可靠性的积极主动的方法。LED失效分析步骤必须遵循先进行非破坏性、可逆、可重复的试验,再做半破坏性、不可重复的试验,最后进行破坏性试验的原则。采用合适的分析方法,最大限度地防止把被分析器件(DUA)的真正失效因素、迹象丢失或引入新的失效因素,以期得到客观的分析结论。针对LED所具有的光电性能、树脂实心及透明封装等特点,在LED早期失效分析过程中,已总结出一套行之有效的失效分析新方法。
2 LED失效分析方法
2.1 减薄树脂光学透视法
在LED失效非破坏性分析技术中,目视检验是使用最方便、所需资源最少的方法,具有适当检验技能的人员无论在任何地方均能实施,所以它是最广泛地用于进行非破坏检验失效LED的方法。除外观缺陷外,还可以透过封装树脂观察内部情况,对于高聚光效果的封装,由于器件本身光学聚光效果的影响,往往看不清楚,因此在保持电性能未受破坏的条件下,可去除聚光部分,并减薄封装树脂,再进行抛光,这样在显微镜下就很容易观察LED芯片和封装工艺的质量。诸如树脂中是否存在气泡或杂质;固晶和键合位置是否准确无误;支架、芯片、树脂是否发生色变以及芯片破裂等失效现象,都可以清楚地观察到了。
2.2 半腐蚀解剖法
对于LED单灯,其两根引脚是靠树脂固定的,解剖时,如果将器件整体浸入酸液中,强酸腐蚀祛除树脂后,芯片和支架引脚等就完全裸露出来,引脚失去树脂的固定,芯片与引脚的连接受到破坏,这样的解剖方法,只能分析DUA的芯片问题,而难于分析DUA引线连接方面的缺陷。因此我们采用半腐蚀解剖法,只将LEDDUA单灯顶部浸入酸液中,并精确控制腐蚀深度,去除LEDDUA单灯顶部的树脂,保留底部树脂,使芯片和支架引脚等完全裸露出来,完好保持引线连接情况,以便对DUA全面分析。图1所示为半腐蚀解剖前后的φ5LED,可方便进行通电测试、观察和分析等试验。

在LED-DUA缺陷分析过程中,经常遇到器件初测参数异常,而解剖后取得的芯片进行探针点测,芯片参数又恢复正常,这时很难判断异常现象是由于封装键合不良导致,还是封装树脂应力过大所造成。采用半腐蚀解剖,保留底部树脂,祛除了封装树脂应力的影响,又保持DUA内部引线连接,这样就很容易确认造成失效的因素。
2.3 金相学分析法
金相学分析法是源于冶金工业的分析和生产控制手段,其实质是制备供分析样品观察用的典型截面,它可以获得用其他分析方法所不能得到的有关结构和界面特征方面的现象[1]。LED的截面分析,是对LED-DUA失效分析的“最后手段”,此后一般无法再进行其他评估分析。它也是一种LED解剖
分析法,为了分析微小样品,在一般试验中,需要对分析样品进行树脂灌封,以便进行机械加工,再对所需要分析的界面进行刨削或切断,然后经过研磨、抛光,获得所要分析的界面。而对LED器件,有很多本身就是树脂灌封器件,这样只要选好界面,就可通过刨削、研磨、抛光等,获得LED- DUA的典型截面。操作中,剖截面通常可用金刚砂纸研磨,当接近所关注的区域时,改用较细的金刚砂纸研磨或水磨,最后在细毛织物上用0.05μm的氧化铝膏剂抛光。图2为φ5白光LED侧向典型截面,可清楚地看到其结构情况。
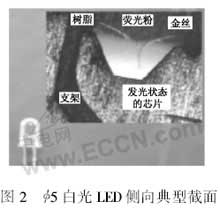
需要注意的是GaN基LED中的蓝宝石衬底异常坚硬,由于目前尚未有较好的研磨方法,因此对这类的DUA还难以对芯片进行截面分析。
用户名: 密码:
