LED封装技术发展的研究与展望
摘要: 从中国LED封装发展历程上看,有传统正装封装用LED芯片、有引线覆晶(Flip-Chip)封装用LED芯片和无引线覆晶封装用LED芯片等几种结构,无引线覆晶LED封装技术是未来LED封装的主流技术。
1.LED 正装芯片封装
正装芯片封装采用银胶或白胶将芯片固定在基板上,通过引线实现电气连接。银胶或白胶含环氧树脂,长期环境稳定性较差,其热阻较高,在LED长时间通电过程中粘接力逐渐变差,易导致LED寿命缩短;且引线很细,耐大电流冲击能力较差,仅能承受10g左右的作用力,当受到冷热冲击时,因各种封装材料的热失配,易导致引线断裂从而引起LED失效。单颗LED芯片正装结构如图2所示。
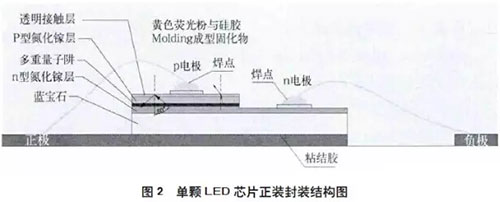
LED正装芯片封装的优点是:①芯片制备工艺成熟;②封装工艺比较成熟。
LED正装芯片封装的缺点是:①电极、焊点、引线遮光;②热传导途径很长:蓝宝石粘结胶支架金属基板;③热传导系数低:蓝宝石热传导率为20W / (m·K)、粘结胶热传导率为2W/ (m·K);④热积累影响芯片和荧光粉可靠性。
2. 有引线覆晶封装
有引线覆晶封装是通过导热粘结胶将LED倒装芯片固定在基板上,再利用金线进行电气连接。其中倒装芯片是通过植金球的方式将LED正装芯片倒装在硅(S i)衬底基板上,并在S i衬底上制备电极,形成倒装芯片。有引线覆晶封装结构图如图3所示。

有引线覆晶封装的优点为:①蓝宝石衬底向上,无电极、焊点、引线遮光,出光效率提升;②传热效果较好,易传导。
有引线覆晶封装的缺点为:①热传导途径较长:金属焊点→硅基板→导热粘结胶→支架热沉;②有引线连接,大电流承受能力有限,存在引线虚焊引起的可靠性问题。
3. 无引线覆晶封装
无引线覆晶封装是通过共晶/回流焊接技术将电极接触面镀层为锡(Sn)或金(Au)-锡等合金的水平电极芯片直接焊接于镀有金或银的基板上,既可固定芯片,又可电气连接和热传导。无引线覆晶封装结构如图4所示。
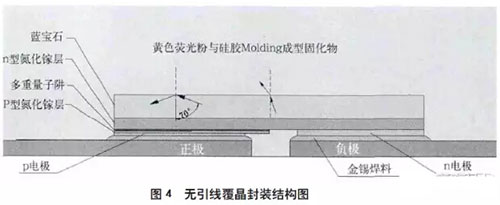
无引线覆晶封装的优点为:①无电极、焊点、引线遮光;②无引线阻碍,可实现平面涂覆荧光粉及超薄封装;③电气连接为面接触,可耐大电流冲击;④热传导途径短:金锡焊点→氮化铝陶瓷/金属基板;⑤金属界面导热系数更高,热阻更小;⑥完全摆脱引线和粘结胶的束缚,表现出优异的力、热、光、电性能。
凡注明为其它来源的信息,均转载自其它媒体,转载目的在于传递更多信息,并不代表本网赞同其观点及对其真实性负责。
用户名: 密码:








