发光二极管(LED)失效分析(图)
摘要: 和半导体器件一样,发光二极管(LED)早期失效原因分析是可靠性工作的重要部分,是提高LED可靠性的积极主动的方法。LED失效分析步骤必须遵循先进行非破坏性、可逆、可重复的试验,再做半破坏性、不可重复的试验,最后进行破坏性试验的原则。
1 引言
和半导体器件一样,发光二极管(LED)早期失效原因分析是可靠性工作的重要部分,是提高LED可靠性的积极主动的方法。LED失效分析步骤必须遵循先进行非破坏性、可逆、可重复的试验,再做半破坏性、不可重复的试验,最后进行破坏性试验的原则。采用合适的分析方法,最大限度地防止把被分析器件(DUA)的真正失效因素、迹象丢失或引入新的失效因素,以期得到客观的分析结论。针对LED所具有的光电性能、树脂实心及透明封装等特点,在LED早期失效分析过程中,已总结出一套行之有效的失效分析新方法。
2 LED失效分析方法
2.1 减薄树脂光学透视法
在LED失效非破坏性分析技术中,目视检验是使用最方便、所需资源最少的方法,具有适当检验技能的人员无论在任何地方均能实施,所以它是最广泛地用于进行非破坏检验失效LED的方法。除外观缺陷外,还可以透过封装树脂观察内部情况,对于高聚光效果的封装,由于器件本身光学聚光效果的影响,往往看不清楚,因此在保持电性能未受破坏的条件下,可去除聚光部分,并减薄封装树脂,再进行抛光,这样在显微镜下就很容易观察LED芯片和封装工艺的质量。诸如树脂中是否存在气泡或杂质;固晶和键合位置是否准确无误;支架、芯片、树脂是否发生色变以及芯片破裂等失效现象,都可以清楚地观察到了。
2.2 半腐蚀解剖法
对于LED单灯,其两根引脚是靠树脂固定的,解剖时,如果将器件整体浸入酸液中,强酸腐蚀祛除树脂后,芯片和支架引脚等就完全裸露出来,引脚失去树脂的固定,芯片与引脚的连接受到破坏,这样的解剖方法,只能分析DUA的芯片问题,而难于分析DUA引线连接方面的缺陷。因此我们采用半腐蚀解剖法,只将LEDDUA单灯顶部浸入酸液中,并精确控制腐蚀深度,去除LEDDUA单灯顶部的树脂,保留底部树脂,使芯片和支架引脚等完全裸露出来,完好保持引线连接情况,以便对DUA全面分析。图1所示为半腐蚀解剖前后的φ5LED,可方便进行通电测试、观察和分析等试验。

在LED-DUA缺陷分析过程中,经常遇到器件初测参数异常,而解剖后取得的芯片进行探针点测,芯片参数又恢复正常,这时很难判断异常现象是由于封装键合不良导致,还是封装树脂应力过大所造成。采用半腐蚀解剖,保留底部树脂,祛除了封装树脂应力的影响,又保持DUA内部引线连接,这样就很容易确认造成失效的因素。
2.3 金相学分析法
金相学分析法是源于冶金工业的分析和生产控制手段,其实质是制备供分析样品观察用的典型截面,它可以获得用其他分析方法所不能得到的有关结构和界面特征方面的现象[1]。LED的截面分析,是对LED-DUA失效分析的“最后手段”,此后一般无法再进行其他评估分析。它也是一种LED解剖
分析法,为了分析微小样品,在一般试验中,需要对分析样品进行树脂灌封,以便进行机械加工,再对所需要分析的界面进行刨削或切断,然后经过研磨、抛光,获得所要分析的界面。而对LED器件,有很多本身就是树脂灌封器件,这样只要选好界面,就可通过刨削、研磨、抛光等,获得LED- DUA的典型截面。操作中,剖截面通常可用金刚砂纸研磨,当接近所关注的区域时,改用较细的金刚砂纸研磨或水磨,最后在细毛织物上用0.05μm的氧化铝膏剂抛光。图2为φ5白光LED侧向典型截面,可清楚地看到其结构情况。
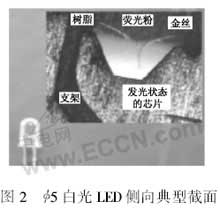
需要注意的是GaN基LED中的蓝宝石衬底异常坚硬,由于目前尚未有较好的研磨方法,因此对这类的DUA还难以对芯片进行截面分析。
2.4 析因试验分析法
析因试验是根据已知的结果,去寻找产生结果的原因而进行的分析试验[2]。通过试验,分清是主要影响还是次要影响的因素,可以明确进一步分析试验的方向。析因试验分析是一种半破坏性试验。LED-DUA解剖分析对操作过程要求较高,稍不留神即可能造成被分析器件的灭失。分析过程中,经常先采用析因试验分析法,分析工程师根据复测结果和外观检查情况,综合相应理论知识和以往积累的分析经验,估计器件失效原因,并提出针对性试验和方法进行验证。一般可采用相应的物理措施和试验———冷热冲击试验、重力冲击试验、高温或低温试验和振动试验等。例如库存φ5透明红光LED单灯,出货检验时出现个别LED间歇开路失效现象,而两次检测只经过搬动运输,故先对DUA采用重力冲击试验,出现试验后开路失效,减薄树脂后看到芯片与银浆错位,是造成间歇开路失效的原因。
2.5 变电流观察法
作为光电器件的LED,与一般半导体器件相比,其失效分析除检测DUA的电参数外,还必须关注光参数方面的变化。除了通过专业测试仪检测外,还可直接通过眼睛或借助显微镜观察DUA的出光变化情况,经常可以得到预想不到的收获。如果DUA按额定电流通电,观察时可能因出光太强而无法看清,而通过改变电流大小,可清晰地观察到其出光情况。例如GaN基蓝光LED正向电压Vf大幅升高的现象,在小电流下,有些可以观察到因电流扩展不良而造成芯片只有局部发光的现象,显然为电极与外延层间接触不牢靠,在封装应力的作用下,接触电阻变大所造成的失效。图3为经减薄处理后φ5LED所观察到的芯片小电流扩展不良现象。

2.6 试验反证法
LED失效分析过程中,经常受到分析仪器设备和手段的限制,不能直观地证明失效原因,高素质的分析工程师,经常通过某些分析试验,采取排除的办法,推论反证失效原因。例如DUA为8×8红光LED点阵,半成品初测合格,灌胶后出现单点LED反向漏电流特大,受仪器设备限制,只有直流电源和LED光电参数测试仪,不能做解剖或透视分析,测试中发现DUA正向光电参数无异常,而反向漏电流大,故采用反向偏置并加大电流至数十毫安后,再测正向光电参数,前后结果无明显变化,说明反向偏置中的数十毫安并非从该LED芯片通过,由此推定并非LED芯片造成漏电。
3 案例分析
3.1 结温过高造成1W白光LED严重光衰
失效现象:特殊照明用1W白光LED连续通电两周后严重光衰。
解析过程:进行光电参数测试,除光通量严重下降外,其他电参数未见异常,同时发现使用环境散热差,使用中器件外壳温度很高。初步认为芯片结温过高造成严重光衰。根据阿仑尼斯模型给出计算不同结温的期望工作寿命和激活能的公式
P=P0exp(-βt)
β=β0Ifexp(-Ea/kTj)
式中: P0为初始光通量; P为加温加电后的光通量;β为某一温度下的衰减系数; t为某一温度下的加电工作时间;β0为常数; Ea为激活能;k为波耳兹曼常数(862×10-5eV);If为工作电流;Tj为结温;而
Tj=Tc+VfIfRj-c
式中:Tc为DUA的外壳温度;Vf为正向电压;Rj-c为芯片结到壳的热阻[3]。
可见LED光通量的衰减快慢为系数β所决定,衰减系数β的大小又取决于结温Tj的高低,而降低结温Tj是通过降低外壳温度Tc和结到壳的热阻Rj-c来实现的。据此,我们采用析因试验分析法,对DUA采取临时应急降温措施,光衰得到明显改善,即确定温度过高是造成光衰的主要因素。为了彻底解决问题,我们检查和改善器件热通道上的各环节,通过X光透视检查芯片的倒装质量未见异常(图4),排除芯片缺陷造成热阻Rj-c过大的可能;改用共晶焊键合降低热阻Rj-c,加大散热器尺寸降低外壳温度Tc,并在应用中增加通风设计,达到降低芯片结温Tj的目的,最终使光衰问题得到解决。
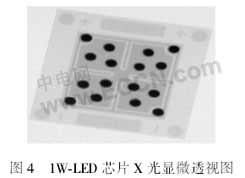
3.2 ESD损伤致LED反向漏电流大
失效现象:φ5透明蓝光GaN-LED单灯反向漏电流大。
解析过程:进行光电参数测试,该LED器件反向漏电流大,在5V的反向电压下,漏电流为50~200μA,先用减薄树脂光学透视法,在立体显微镜下观察封装情况,打线键合及固晶等均未发现异常;由于蓝光GaN-LED为静电敏感器件,初步判定反向漏电流大是静电放电(ESD)损伤所致;再
用半腐蚀解剖法解剖DUA,在高倍显微镜下,可清楚看到芯片静电放电损伤的击穿点,详见图5,初期判断得到印证。
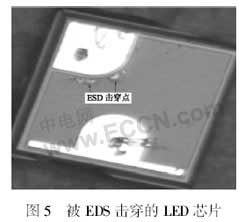
3.3 内气泡致LED单灯开路
失效现象:φ5透明蓝光GaN-LED单灯使用中先闪烁后熄灭。
解析过程:通电进行参数测试,DUA呈开路状态,采用减薄树脂光学透视法分析,在立体显微镜下观察封装情况,发现支架杯中芯片n电极边上有一气泡,其他部分未发现异常(图6),由于芯片出现开路的可能性极低,所以判断应为引线开路。解剖器件,发现n极金线焊球脱离芯片电极造成开路,因而使器件熄灭,判断得到印证。

3.4 二焊开路造成LED死灯
失效现象:φ5透明蓝光GaNLED单灯使用中熄灭。
解析过程:通电进行参数测试,DUA呈开路状态,先用减薄树脂光学透视法,在立体显微镜下观察封装情况,除p电极金丝二焊点外,其他部分未发现异常;p电极二焊点金丝线体和焊接面厚度变化较为剧烈,过度不够平滑。采用减薄树脂光学透视法,仍然无法看清开路点。再用半腐蚀解剖法,解剖后可明显看到p电极金丝二焊点断开(图7),造成器件熄灭,判断得到印证。

4 注意事项
4.1 静电防护
GaN基LED是静电敏感器件,容易因静电放电损伤,引起短路或漏电流大,反向呈软击穿特损伤,引起短路或漏电流大,反向呈软击穿特性。失效模式分为两种:一为突发性失效,表现为pn结短路,LED不再发光;一为潜在性缓慢失效,例如带电体静电势或存贮的能量较低,一次ESD不足以引起发生突然失效,表现为漏电流加大、反向呈软击穿特性,甚至亮度大幅度下降、光色(主波长)出现变化等。它会在芯片内部造成一些损伤,这种损伤是积累性的,随着ESD次数的增多,LED的光电参数逐渐劣化,最后完全失效[4]。因此,在整个分析过程中,必须始终做好静电防护工作,防止静电损伤DUA,否则可能导致完全错误的失效分析结论。
4.2 焊接散热保护
因分析或测试等需要对DUA进行烙铁加热焊接的,焊接前须评估烙铁加热过程对DUA造成的损坏和改变的可能性。如果需要焊接的,应对引脚进行散热保护,例如用金属镊子夹住DUA引脚根部,并缩短焊接时间,防止因过热而改变或损害DUA的内部焊点。
5 结束语
LED理论上的寿命是很长的,可达105h,早期失效一般是由于设计、材料、结构、工艺和使用等环节上存在一些缺陷所引起的,无论从使用现场还是试验中获得失效器件,均可采用本文中的一种或数种分析方法结合并用,寻找、确定失效原因,以便进一步完善LED制造技术,使LED的长寿命、高可靠的优点得到充分的体现。
凡注明为其它来源的信息,均转载自其它媒体,转载目的在于传递更多信息,并不代表本网赞同其观点及对其真实性负责。
用户名: 密码:








