倒装芯片(Flip chip)是一种无引脚结构,一般含有电路单元。设计用于通过适当数量的位于其面上的锡球(导电性粘合剂所覆盖),在电气上和机械上连接于电路。
Flip-Chip(倒装芯片)
Flip chip又称倒装片,是在I/O pad(输入/输出焊盘)上沉积锡铅球,然后将芯片翻转加热利用熔融的锡铅球与陶瓷基板相结合,此技术替换常规打线接合,逐渐成为未来的封装主流,当前主要应用于高时脉的CPU(中央处理器)、GPU(Graphic Processor Unit)(图形处理器)及Chipset (芯片组)等产品为主。与COB(板上芯片封装)相比,该封装形式的芯片结构和I/O端(锡球)方向朝下,由于I/O引出端分布于整个芯片表面,故在封装密度和处理速度上Flip chip已达到顶峰,特别是它可以采用类似SMT(表面贴装)技术的手段来加工,因此是芯片封装技术及高密度安装的最终方向。倒装片连接有三种主要类型:C4(倒塌的芯片控制连接)、DCA(直接芯片连接)和FCAA(倒装芯片粘合剂)。
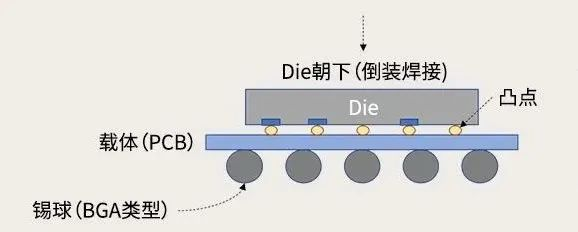
C4是类似超细间距BGA的一种形式与硅片连接的焊球阵列一般的间距为0.23、 0.254mm。焊球直径为0.102、0.127mm。焊球组份为97Pb/3Sn。这些焊球在硅片上可以呈完全分布或部分分布。由于陶瓷可以承受较高的回流温度,因此陶瓷被用来作为C4连接的基材,通常是在陶瓷的表面上预先分布有镀Au或Sn的连接盘,然后进行C4形式的倒装片连接。
C4连接的优点在于:1)具有优良的电性能和热特性;2)在中等焊球间距的情况下,I/O数可以很高;3)不受焊盘尺寸的限制;4)可以适于批量生产;5)可大大减小尺寸和重量。
DCA和C4类似是一种超细间距连接。DCA的硅片和C4连接中的硅片结构相同,两者之间的唯一区别在于基材的选择。DCA采用的基材是典型的印制材料。DCA的焊球组份是97Pb/Sn,连接焊接盘上的焊料是共晶焊料(37Pb/63Sn)。对于DCA由于间距仅为0.203、0.254mm共晶焊料漏印到连接焊盘上相当困难,所以取代焊膏漏印这种方式,在组装前给连接焊盘顶镀上铅锡焊料,焊盘上的焊料体积要求十分严格,通常要比其它超细间距元件所用的焊料多。在连接焊盘上0.051、0.102mm厚的焊料由于是预镀的,一般略呈圆顶状,必须要在贴片前整平,否则会影响焊球和焊盘的可靠对位。
FCAA连接存在多种形式,当前仍处于初期开发阶段。硅片与基材之间的连接不采用焊料,而是用胶来代替。这种连接中的硅片底部可以有焊球,也可以采用焊料凸点等结构。FCAA所用的胶包括各向同性和各向异性等多种类型,主要取决于实际应用中的连接状况,另外,基材的选用通常有陶瓷,印刷板材料和柔性电路板。倒装芯片技术是当今最先进的微电子封装技术之一。它将电路组装密度提升到了一个新高度,随着21世纪电子产品体积的进一步缩小,倒装芯片的应用将会越来越广泛。
Flip-Chip(倒装芯片)的特性
Flip-Chip(倒装芯片)封装技术与传统的引线键合工艺相比具有许多明显的优点,包括,优越的电学及热学性能,高I/O引脚数,封装尺寸减小等。
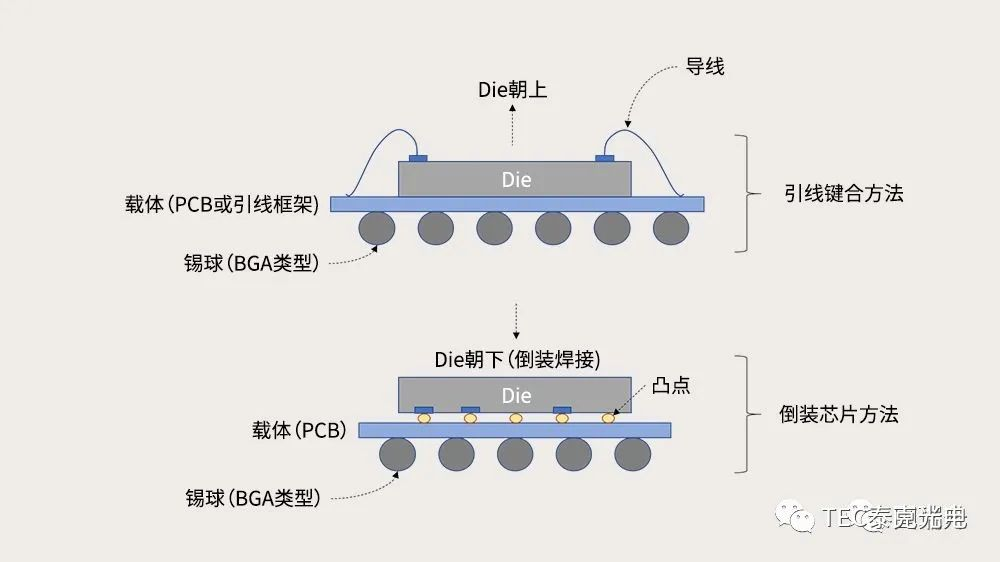
Flip-Chip(倒装芯片)封装技术的热学性能明显优越于常规使用的引线键合工艺。如今许多电子器件;ASIC(专用集成电路),微处理器,SOC(系统级芯片)等封装耗散功率10-25W,甚至更大。而增强散热型引线键合的BGA器件的耗散功率仅5-10W。按照工作条件,散热要求(最大结温),环境温度及空气流量,封装参数(如使用外装热沉,封装及尺寸,基板层数,球引脚数)等,相比之下,Flip-Chip封装通常能产生25W耗散功率。
Flip-Chip(倒装芯片)封装杰出的热学性能是由低热阻的散热盘及结构决定的。芯片产生的热量通过散热球脚,内部及外部的热沉实现热量耗散。散热盘与芯片面的紧密接触得到低的结温(θjc)。为减少散热盘与芯片间的热阻,在两者之间使用高导热胶体。使得封装内热量更容易耗散。为更进一步改进散热性能,外部热沉可直接安装在散热盘上,以获得封装低的结温(θjc)。
Flip-Chip(倒装芯片)封装另一个重要优点是电学性能。引线键合工艺已成为高频及某些应用的瓶颈,使用Flip-Chip封装技术改进了电学性能。如今许多电子器件工作在高频,因此信号的完整性是一个重要因素。在过去,2-3GHZ是IC封装的频率上限,Flip-Chip封装根据使用的基板技术可高达10-40 GHZ 。
倒装芯片的测试
Flip-Chip(倒装芯片)的测试需要用专用测试机测试。泰克光电研发的PT-198A倒装芯片测试机,是国内技术领先的全自动的倒装芯片测试机。

泰克光电倒装芯片测试机
泰克光电倒装芯片测试机,其主要有以下特点:
llProber & Tester 整合一体机设计,具有业界领先的测试速度与精度;
l日制高精密丝杆导轨,机械刚性强,使用寿命长,同时与精密光栅尺组合实现运动全闭环控制,具有超高精度的定位精度与长期运行的精度稳定性;
l整机采用仪用大理石平台与整机下沉式设计,具有极好的运行平稳性;
l机构尺寸优化缩小,提高厂房利用率;
l自主研发的实时称重式主动电极寻边器,能有效的控制好每次测试时探针与芯片电极之接触力度,保证针痕的一致性;
l自主倒装收光 结构,具有更高的光学灵敏度与精度,适用于最大6“ [*注1] 之 Mini-LED芯片、常规正倒装芯片、CSP 芯片测试;
l可选配1“、1.5”、2”之积分球,配置7档滤光片,以适用于不同亮度之芯片测试要求,可测量微电流点亮;
l多针设计,可实现多颗同时测量之要求,提高机器的测试产能;
l具有自动清针功能;
l机器配置有变倍针痕拍照相机,生产中自动拍摄针痕确认功能,保证稳定生产。











