最全解读LED COB封装关键技术
|
上传人:广东LED 上传时间: 2016-12-05 浏览次数: 497 |
LED COB(Chip On Board)封装是指将LED芯片直接固定在印刷线路板(PCB)上,芯片与线路板间通过引线键合进行电气连接的LED封装技术。其可以在一个很小的区域内封装几十甚至上百个芯片,最后形成面光源。与点光源封装相比,COB面光源封装技术具有价格低廉(仅为同芯片的1/3左右)、节约空间、散热容易、发光效率提高、封装工艺技术成熟等优点。
由于散热性能优越及制造成本低廉,COB封装LED光源受到很多封装企业的热捧。对于大功率COB封装,散热是影响其长期可靠性的至关重要的因素。COB封装产品结点温度升高会降低LED的整体效率,降低正向电压,导致发射光红移,降低使用寿命及可靠性。
LED的散热研究主要包括3个层次:封装、基板和整体层次。在解决大功率COB封装的散热问题时,大多数研究者是先提出结构模型,并通过软件(有限元分析软件ANSYS、计算流体力学软件CFD等)模拟一定条件下整个封装结构的散热过程及各部位的温度,再进行实验验证模拟结果。此外,影响大功率COB封装性能的一个重要因素是封装胶的性能。
1、大功率LED COB封装用硅胶性能
目前市场上可用于大功率LED COB封装的硅胶种类繁多,其中数量较多的是国产硅胶,其主要优势是价格低廉。下表1对比了目前市场上部分硅胶的性质。

从上表1中可以看出,硅胶的折射率可分为两个主要档次:低折射率(1.42)和高折射率(1.54)。在封装过程中使用高折射率的硅胶可以有效减少光子在界面的损失,从而提高光源的光通量。
另外一个影响硅胶性能的重要参数是透光率。从表中看出,大部分封装硅胶的透光率都能达到98%以上,其中道康宁公司的OE-6550硅胶的透光率达到100%,且折射率达到1.543,固化条件简单,只需在150℃固化1h即可,耐温范围宽(-60~200℃),性能上具有很大优势,但缺点是价格昂贵(售价5 700~6 800元/kg)。
对比性能还可以看出,很多国产硅胶的性能已经接近于道康宁的这款产品。也有一些商家称其硅胶完全可以取代OE-6550硅胶用于LED的封装。
2、大功率LED COB封装的研究进展
COB集成式封装相对于单颗分立式封装具有更好的散热性能,主要是由于COB封装是芯片直接将热量传导到基板上再通过基板传导到外壳。而大功率COB封装中,多个大功率芯片近距离地集成在一起,散热问题还是要首先解决的问题。针对这点,国内外众多研究者在软件模拟的基础上对COB封装散热进行了研究。
(1)兰海等利用有限元热仿真模拟的方法对COB封装过程中常用的金属基板和陶瓷基板进行分析,得到的结论是,利用陶瓷基板作为封装材料的热阻是金属基板热阻的1/2,并且陶瓷基板还具有更大的热管理优化空间。
(2)马建设等利用TracePro软件仿真和实验在同时考虑荧光粉涂覆方式和反光杯结构的条件下分析了影响COB封装LED发光性能的主要因素,研究结果表明,利用角度为30°、杯深略大的圆锥形反光杯进行封装,产品发光性能较好,采用荧光粉远离芯片的方式涂覆荧光粉可使其发光效率提高5%左右。
(3)李伟平等提出一种新型COB自由曲面透镜封装结构(如下图1),采用TracePro对该结构进行模拟,结果表明,器件可实现特定的光学分布,并且出光效率高于90%。
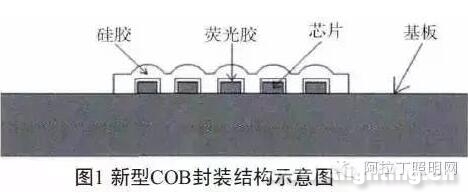
(4)姜斌等提出了3种LED COB封装方法,封装结构分别为COB-Ⅰ、COB-Ⅱ和COB-Ⅲ,示意图如下图2。有限元模拟和实验测量结果表明,COB-Ⅲ的芯片结温比COB-Ⅱ、COB-Ⅰ分别低21.5℃和42.7℃,热阻分别低25.7K/W和58.8K/W,而且COB-Ⅲ光衰也更小。
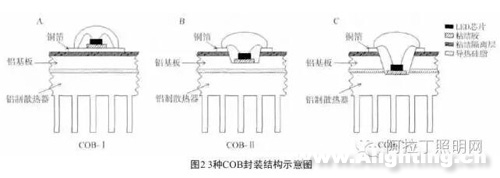
(5)Hsueh-HanWu等提出了5种不同芯片间距的大功率COB封装形式,其中最大芯片间距为2.5mm,CFD软件模拟和实验测定结果表明,芯片间距越大,结温越低、光通量和发光效率越高,并且结温最大值与最小值之间相差3.12℃。
(6)Jae-KwanSim等提出采用低温共融陶瓷进行LED COB封装(LTC-CCOB)(封装结构模型示意图如下图3(a))以提高其热性能,在LED芯片与金属基板之间没有绝缘层,实验对比分析了它与SMD-COB封装形式(如下图3(b))的性能参数,结果表明:LTCC-COB封装的电致发光峰值强度是SMD-COB封装的1.75倍;LTCC-COB封装及SMD-COB封装的封装表面与空气之间的热阻分别为7.3K/W和7.9K/W。
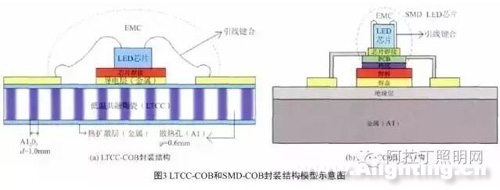
(7)2013年ChangKeunLee等也研究了LTCC-COB封装的散热性能,其LED封装结构是将低温共融陶瓷直接安装在金属基印刷线路板(MCPCB)上,采用有限体积数值模拟法(主要采用嵌入商业软件FluentV.6.3)研究了LED模组的热性能,软件模拟的结果与实验结果一致,结果表明:整个基板的热阻有49%~58%来自于MCPCB的热阻;实验建立的模型克服了传统LTCC大功率LED模组热阻大的缺陷。
(8)YuHui等研究了一种新型的LED晶圆级COB封装形式,该封装形式使用微玻璃泡帽和硅基片作为封装材料。系统地研究COB的封装过程,包含以下步骤:①准备好带有引线的硅基片;②利用焊线设备将LED固定在硅基片上;③荧光粉均匀地涂覆在玻璃泡帽的内球面;④在球形玻璃泡帽内填满硅胶;⑤将固定在硅基片上的LED封入球形玻璃泡帽内。实验结果表明:该形式的COB封装实施成功并且封装的芯片具有良好的热性能和发光性能。
用户名: 密码:
