冯亚凯 天津大学化工学院教授
《2018阿拉丁照明产业照明白皮书》关键材料 顾问
谭雨涵 北京十三中学
一、LED封装技术与材料综述
LED是半导体发光二极管,现已广泛应用于照明、显示、信息和传感器等诸多领域。LED器件按功率及用途要求,采用相应的封装材料,主要包括环氧树脂、有机硅树脂和无机封装材料等。
封装材料和封装工艺、封装设备需要互相匹配,他们基本是一一对应的关系。LED封装的主流方式有以下几种:
1)基于液态胶水的点胶灌封;
2)基于固态 EMc 的Transfer Molding转进注射成型;
3)基于半固化胶膜的真空压合成型;
4)其他特殊封装方式,如基于液态树脂的模具注射成型、基于触变胶水的刷涂或印刷、喷涂等封装工艺。
1.1 点胶灌封技术
点胶灌封技术是LED封装常用的标准工艺,点胶工艺的核心设备包括点胶机(有气压、柱塞泵、齿轮泵等供料方式)、一体成型的带围坝或反射杯的金属支架,封装材料为双组分或单组份胶水。无论液态环氧树脂还是液态有机硅胶水,基本采用双组分包装方式,这是因为双组分有利于材料的长期存储,但点胶灌封前,他们需经过充分混合达到均一才能使用。为了将胶水与无机材料(例如荧光粉)充分混合,就必须借助于高速双行星分散机,这样才能确保无机材料在有机树脂内的均一分散。混合后的材料需按供应商的推荐操作方法进行LED的封装,并且在规定时间内用毕,否则,无机材料无法在液态胶水中长期稳定分散,会发生团聚和沉降现象。此外,A、B组分混合后,即使在室温储存,也会发生化学交联或吸湿,从而影响材料的黏度稳定。环氧树脂主要以酸酐作为固化剂,配置成加成反应型封装材料,这种环氧树脂是A、B双组分配方。此外,环氧树脂还可以基于阳离子反应机理配置成单组份胶水。这种阳离子反应配方材料更具耐热性和耐高温黄变能力,但碍于催化体系成本高,无法普遍使用,仅仅限定在触变性要求较高的封装领域。用 于LED封装应用的有机硅胶水主要是采用金属铂催化含双键的有机硅氧烷与含硅氢的有机硅氧烷的加成反应体系。该反应体系通常配制成A、B双组分封装材料,它们稳定性好,便于储存。LED封装胶水大部分是热固化的材料,也有部分封装材料为了特殊应用而采用UV光固化体系。对于热固化材料,点胶后,胶水需要经过150度约2-5小时的高温烘烤,实现完全固化封装。当树脂固化时,树脂会发生一定的体积收缩,产生收缩应力,这会对树脂与芯片、芯片与银胶的粘结、金线焊点部位、树脂与支架的结合界面等产生一定影响。因此,封装材料和封装工艺对LED器件的系统稳定性有直接关联,封装工程师需要系统细致研究分析,以确定最佳封装工艺和封装材料。
1.2 基于热固性树脂封装材料的转进塑封(Transfer Molding)技术
Transfer Molding 就是转进塑封技术,由塑封机、芯片及其支撑材料、EMC(Epoxy Molding Compound) 封装树脂三大要素构成。主要塑封机设备的分类和生成经济性总结在表1中。

芯片的支撑有金属支架(leadframe)和基板(PCB substrate)两种。正装芯片由导电或非导电固晶胶粘结在支架或基板上(die bonding),再经过金线(部分产品用铝线或铜线)连接芯片和支撑的接点。倒装芯片则通过锡膏或共晶焊接固定到支撑上,免去金线连接(wire bonding)。
LED封装用环氧树脂塑封料EMC是由环氧树脂、固化剂、特种添加剂组成的半固化、常温为固态的树脂材料,呈圆柱状“饼料”。行业通常以直径35mm、46mm、48mm称为“大饼料”,适用于传统塑封机;而直径13mm、14mm、16mm为“小饼料”,适用于MGP模或全自动模机。EMC在封装温度,通常是150°c下开始融化,在塑封机的传输杆推动下,经过流道,注射入含有芯片的模腔中。EMC在高温下会发生固化反应,而失去流动性,塑封机完成转进注射后,经过几分钟的保压,即可确保EMC固化完全,完成LED封装过程。
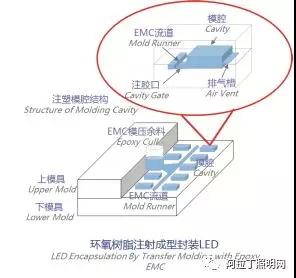
图1是EMC注射成型的示意图
1.3 基于半固化有机硅荧光胶膜的热压合封装技术
胶膜压合技术是近五年新兴的一种中大功率LED的CSP(chip scale package)封装方法。LED CSP结构具有光色均一、散热结构优良、贴装尺寸小等优势,在电视背光、手机背光、车灯、闪光灯、商业照明及智慧照明领域,与传统正装 LED封装形式相比,胶膜压合技术有无法替代的技术优势,将推动LED领域的快速发展。LED行业的CSP概念参考了IC行业的概念,即封装后器件尺寸不超过未封装前裸芯片的1.14倍。LED行业的CSP概念与IC略有不同的是其和倒装芯片技术是紧密结合的,即免除金线连接(Wire Bonding),可直接供灯具厂表贴SMT使用。

图2基于半固化有机硅荧光胶膜的热压合封装技术
封装LED CSP的核心技术是在芯片的五个出光面形成厚度可控、且均匀一致的荧光胶层。在胶膜法技术成熟之前,多采用喷涂荧光胶水的方式在芯片表面形成荧光层。喷涂工艺根据LED色温设计,需要反复喷涂 7-15次才能达到设计要求,因此生产效率不佳。荧光胶膜压合法,借助于精密的压合设备和压合治具、以及半固化荧光胶膜的稳定和均一性,能够以较高精度和效率制作CSP,大幅度地提高生产效率。

图3是胶膜压合法的原理图
荧光胶膜压合法工艺的核心步骤是:倒装芯片在耐热胶膜上阵列置晶、与预制的荧光胶膜在真空压合治具内结合、5-10分钟的真空保压及胶膜固化、硬化胶膜及芯片阵列的切割。真空压合设备需具备上、下模板高精度控温、快速抽真空、软合模行程控制等工艺基本能力。以35mil*35mil的倒装芯片为例,一块标准 100mm*100mm的压合治具可以容纳6000颗芯片阵列;已成熟量产的压合机操作台面,一次性可放置4片标准压合治具,由此可以得出单机台的CSP的生产能力(以压合周期10分钟计)为144K/hr。因此,荧光胶膜压合法是高效率、低成本、易掌控的CSP制造方法。
二、LED封装新兴细分领域的封装材料
按照材料化学组成分类,LED封装材料主要包括环氧树脂和有机硅两大类;而按照封装应用和封装工艺方式分类,封装材料又有更多细分。表2给出了封装材料形态、 封装工艺、封装产品应用及材料供方竞争态势。

2.1 细分市场一: 环氧EMC封装小功率指示用ChipLED
小功率LED用于指示灯的器件采用基板或金属支架封装的ChipLED,因产量大、良率和效率竞争激烈,生产厂商基本采用transfer Molding方式用固态环氧树脂封装。主流产品包括红光、绿光、蓝光和黄光的ChipLED 0603,0805,1206 等,可以是单色、双色或RGB全彩。

图 4 环氧EMC封装小功率指示用ChipLED
这一领域因白色家电和消费电子对器件可靠性要求适中,封装材料EMC主要强调:
(1)对PCB基板以及镀 银金属支架的粘结;
(2)树脂耐回流焊温度,不发生热应 力死灯;
(3)耐返修解焊高温不变黄。这一细分领域代表材料有日东电工NT-8524、长春化工CV1002和德高化成TC-8020等。
2.2 细分市场二:小功率白光ChipLED
除彩色chipLED外,指示灯应用还有白光器件的需求; 另外,白光ChipLED 还可以应用在单色LCD背光、汽车氛围灯、汽车显示屏背光等高端应用。这类 LED器件,因功率较低(<0.2W),不必采用耐受蓝光能力更高的有机硅材料,而是采用中高耐蓝光环氧树脂EMC混合荧光粉,以transfer Molding方式封装。这一细分市场多采用SOL Epoxy的OP-1000、日东NT-600H、NT-814、 德高化成CT-8500、TC-8600等牌号。
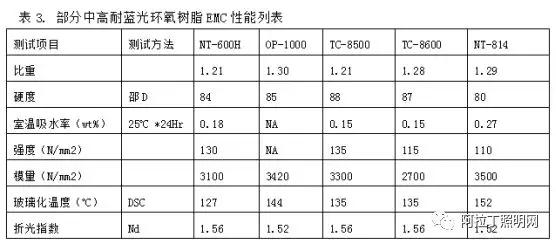
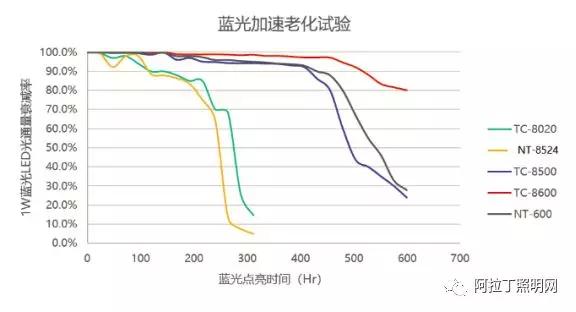
图 5 部分中高端耐蓝光环氧EMC的光衰对比
封装用户混合荧光粉的最大难点在于干混法的分散均一性。由于EMC厂商提供的胶饼一般呈圆柱颗粒状,封装厂需先行粉碎,再与荧光粉按比例混合,并再一次打饼成胶粒,这一过程为干混法。从分散均一性来看,树脂的粉末平均粒径越接近荧光粉粒径(一般为D50=8-16um)、且树脂粉粒径分布半峰宽越窄,荧光粉的分散均一度就越高,白光LED的落BIN就越集中。树脂粉碎的粒径控制是非常专业的粉体制造过程,需要专业的设备与品质管控。目前,部分国内EMC厂商已经顺应市场要求,以粉体成品方式提供EMC材料。
2.3 细分市场三:小间距RGB LED显示屏用环氧树脂EMC
近年来,市场增长最快的LED细分产品是RGB显示屏。普通间距(P>3)RGB仍采用液态环氧灌封形式,应用较为集中的封装尺寸有1921、2121、3030、5050(反射杯外型尺寸),封装树脂较流行应用稻田H2002(户内)及IK1001(户外)。
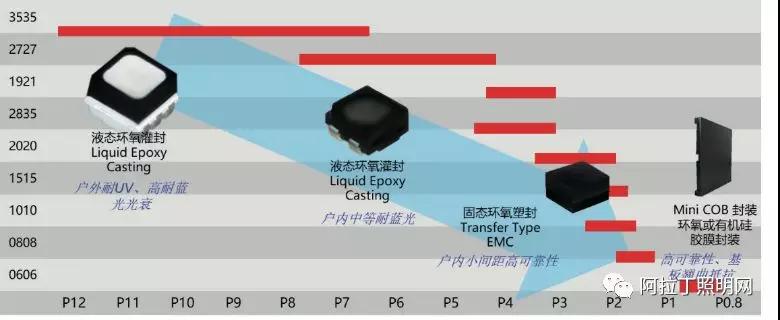
图 6 RGB 屏封装尺寸与封装方式
市场热点的小间距RGB屏(P<1.9)则采用transfer Molding方式,由整块基版阵列固晶打线,通过over Molding成型、然后切割(singulation),制成五面发光的EMc1010及EMC0808。新一代基于R、G、B倒装芯片的Mini-COB,向着更小间距及控制IC集成化、模块化发展,家用tV将有望从LCD的Passive Mode 进入LED的Active Mode时代。
RGB显示屏因长期高温状态下工作,LED器件需通过严格的PCT及TCT测试。封装树脂的粘结能力、耐潮气渗透、不纯离子杂质含量是影响RGB器件可靠性的关键因素。特别是沿海城市的盐雾侵蚀,是RGB屏死灯及常亮的失效主要原因。失效原理如图7所示。

图7 RGB器件失效原理示意图
此外,户外RGB屏一般需要全功率点亮,而且,需要抵抗太阳紫外线的照射,这就要求封装材料耐蓝光光衰能力36个月保持80%以上。户内屏功率开启一般在30%- 50%,对封装材料耐光衰能力的要求稍低。此外,RGB屏的返修解锡过程的高温易造成封装材料黄变,这就需要树脂有较强耐高温性能。这一细分领域可选的封装材料不多,除少数厂商使用有机硅树脂封装外,日东电工的高可靠性树脂nt-600H基本是市场垄断材料。最近,德高化成推出氯离子不纯物含量相比nt-600H降低70%的更高可靠性EMC TC-8600,有望为RGB封装用户提供更多材料选择。
小间距EMC五面出光灯珠的封装型号(尺寸)主要有EMC1010、EMC0808、EMC0606。由于基板材料的热膨胀系数(CTE)为4-7ppm/degc,而纯环氧树脂的热膨胀系数为60-70ppm/degc,这两种材料的热膨胀系数之差非常大,导致封装后整板材料翘曲。基板厚度越薄,则翘曲越发明显,甚至翘曲影响后道切割工序的进行。为了减小翘曲,可行的方法是降低环氧树脂封装材料的CTE(热膨胀系数),通常添加无机粉体材料得到环氧树脂-无机物复合材料,使其CTE接近基板材料的CTE。这一技术在IC行业封装树脂中广泛应用并且成熟,然而,普通的无机粉体或者不透明,或者离子不纯物含量超标,无法应用在RGB EMC透明环氧树脂体系中。德高化成近期发表了添加特殊透明粉体的TC-8600F环氧树脂-透明填料复合体系产品,该体系添加的粉体材料与环氧树脂有一致的光学折射率,可保证光线透过率接近纯环氧树脂。

表4. 添加特殊透明粉体的TC-8600F环氧树脂-透明填料复合体系的热膨胀系数

图8添加50%透明粉体的TC-8600F明显消除翘曲效果图
2.4 细分市场四:光谱选择透过/吸收EMC
随着智能手机、穿戴设备、物联网、大尺寸LCD白板的兴起,红外通讯、环境光传感器、接近光传感器等一系列红外器件迅速发展起来。传感器的工作原理是通过对光谱的选择性过滤,由LED芯片对特定波长光线生成电信号反馈,达到开关控制目的。封装树脂通过添加某些过滤物质,可以实现对可见光(550nm特征波长)或红外光(840nm特征波长)的选择性透过,而屏蔽其他波段光线进入芯片。可见光透过的器件可以做成环境光传感器,而红外光透过的器件可以与可见光透过器件组合,做成接近光传感器。选择性强且透过率高的过滤添加物目前尚待国产化。一般的红外器件基本采用普通EMC封装。某些新开发的封装形式结构复杂、出现球头填充不良、应力开裂、耐高温工作失效等技术问题,有待树脂厂家从流动性设计、高tg、低模量等方向持续改善。

图9染料与波段过滤图








